本文介紹了 1200 V SiC MOSFET 的短路能力和使用現(xiàn)成驅(qū)動(dòng)器 IC 的過(guò)流保護(hù)解決方案?討論了幾個(gè)設(shè)計(jì)注意事項(xiàng),以確保準(zhǔn)確的測(cè)量?測(cè)試結(jié)果表明,SiC MOSFET 的短路能力與漏極電壓和柵極電壓高度相關(guān),但對(duì)外殼溫度和開(kāi)關(guān)速度不敏感?通過(guò)降低柵極驅(qū)動(dòng)電壓或降低總線(xiàn)電壓可以實(shí)現(xiàn)更長(zhǎng)的耐受時(shí)間,但這些解決方案會(huì)降低 SiC MOSFET 的性能?(君芯-MOS)
更好的解決方案是實(shí)施過(guò)流保護(hù)以檢測(cè)設(shè)備過(guò)流并安全關(guān)閉設(shè)備?具有去飽和保護(hù)的商用IGBT驅(qū)動(dòng)器可以有效保護(hù)SiC MOSFET,但需要優(yōu)化電路以確保去飽和保護(hù)的總響應(yīng)時(shí)間足夠短以保護(hù)SiC MOSFET?比較了各種具有去飽和保護(hù)功能的現(xiàn)成柵極驅(qū)動(dòng) IC 的性能,并展示了可以在真實(shí)短路條件下保護(hù) 1200V SiC MOSFET 的柵極驅(qū)動(dòng)設(shè)計(jì)?
由于其極低的開(kāi)關(guān)損耗,碳化硅 (SiC) MOSFET 為最大限度地提高功率轉(zhuǎn)換器的效率提供了廣闊的前景?然而,在確定這些設(shè)備是否是實(shí)際電源轉(zhuǎn)換應(yīng)用的實(shí)用解決方案時(shí),它們的短路魯棒性長(zhǎng)期以來(lái)一直是討論的話(huà)題?
由于相對(duì)較小的芯片尺寸,更高的短路電流密度和更小的熱容意味著 SiC MOSFET 的短路耐受時(shí)間比類(lèi)似額定值的硅 IGBT 短?幸運(yùn)的是,最近對(duì) 1200 V?80 mΩ SiC MOSFET的一項(xiàng)研究表明,支持更快響應(yīng)時(shí)間的正確柵極驅(qū)動(dòng)設(shè)計(jì)可以保護(hù) SiC MOSFET 免受短路損壞?本研究將討論 1200 V?80 mΩ SiC MOSFET 的短路能力?展示和解釋了在各種操作條件下執(zhí)行的破壞性測(cè)試收集的結(jié)果,以及從應(yīng)用和設(shè)備角度進(jìn)行的設(shè)計(jì)權(quán)衡?此外,本研究的另一部分比較了各種具有去飽和保護(hù)功能的現(xiàn)成柵極驅(qū)動(dòng) IC 的性能?,
SiC MOSFET 結(jié)構(gòu)和短路能力
比較額定電流相似的 Si IGBT 和 SiC MOSFET 時(shí),SiC MOSFET 在短路條件下的電流密度高 5-10 倍?更高的瞬時(shí)功率密度和更小的熱容導(dǎo)致更快的溫升和更低的短路耐受時(shí)間?MOSFET 飽和電流主要由溝道區(qū)的設(shè)計(jì)控制?雖然較短的溝道和較高的導(dǎo)通柵極電壓對(duì)于降低導(dǎo)通電阻是可取的,但它們也會(huì)增加飽和電流并減少短路耐受時(shí)間?導(dǎo)通電阻和短路電流之間的這種權(quán)衡是 SiC MOSFET 設(shè)計(jì)中固有的,最好通過(guò)設(shè)計(jì)響應(yīng)時(shí)間比傳統(tǒng) IGBT 柵極驅(qū)動(dòng)更快的柵極驅(qū)動(dòng)來(lái)解決?
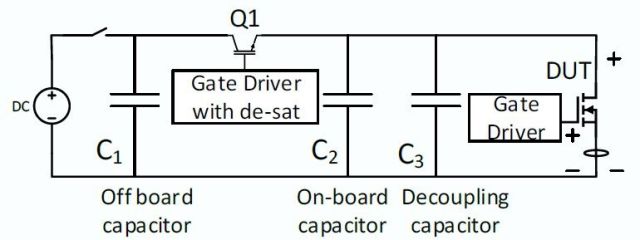
圖 1a:短路測(cè)試電路原理圖?
破壞性短路測(cè)試結(jié)果
測(cè)試電路(圖 1a 和 1b)旨在評(píng)估 1200 V?80 mΩ SiC MOSFET(Littelfuse LSIC1MO120E0080)(圖 2)在各種工作條件下的短路能力?高帶寬?高電壓無(wú)源探頭用于測(cè)量漏源 (V DS ) 和柵源 (V GS ) 電壓;Rogowski 線(xiàn)圈用于器件電流 (I DS ) 測(cè)量?
 圖 1b:短路測(cè)試設(shè)置?一個(gè)丙烯酸外殼圍繞著測(cè)試裝置,以在發(fā)生災(zāi)難性的設(shè)備故障/爆炸時(shí)保護(hù)設(shè)備和實(shí)驗(yàn)者?
圖 1b:短路測(cè)試設(shè)置?一個(gè)丙烯酸外殼圍繞著測(cè)試裝置,以在發(fā)生災(zāi)難性的設(shè)備故障/爆炸時(shí)保護(hù)設(shè)備和實(shí)驗(yàn)者?

圖 2:本次評(píng)估的被測(cè)器件是 Littelfuse LSIC1MO120E0080 系列增強(qiáng)型 1200 V?80 mOhm N 溝道 SiC MOSFET
圖 3 顯示了 10 個(gè)樣品在室溫下 600 V 漏極電壓和 20 V 柵極電壓的短路測(cè)試結(jié)果?圖 4 和圖 5 顯示了破壞性故障的短路耐受時(shí)間和臨界能量結(jié)果?器件的結(jié)果分布緊密,短路電流約為 250 A,所有器件的短路耐受時(shí)間都大于 7 µs?
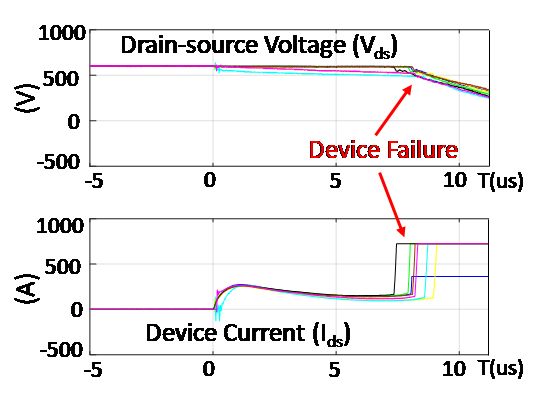
圖 3:不同設(shè)備的短路測(cè)試結(jié)果

圖 4:600 V DC 漏極電壓下的耐受時(shí)間
圖 5:600 V DC 漏極電壓下的臨界能量
圖6所示為20V柵極電壓下200V~800V各種漏極電壓下的短路測(cè)試結(jié)果?雖然峰值電流相似,但在所有條件下250A左右,短路耐受時(shí)間從20多200 V 漏極電壓為 µs,800 V 為 3.6 µs?隨著直流總線(xiàn)電壓的增加,瞬時(shí)功耗也顯著增加?因此,溫升更快,導(dǎo)致短路耐受時(shí)間更低?
圖 7 顯示了柵極電壓為 15 V 和 20 V 且漏極電壓為 600 V 的測(cè)試結(jié)果?這些結(jié)果表明峰值電流強(qiáng)烈依賴(lài)于柵極電壓,從 20 V 柵極電壓下的 250 A 降低到 100 A 15 V 柵極電壓,支持設(shè)計(jì)權(quán)衡理論,關(guān)于驅(qū)動(dòng)電壓/導(dǎo)通電阻/短路峰值電流和耐受時(shí)間關(guān)系,本文前面已討論過(guò)?已研究但證明對(duì)器件的短路耐受時(shí)間沒(méi)有明顯影響的其他因素是器件的外柵極電阻和環(huán)境溫度?
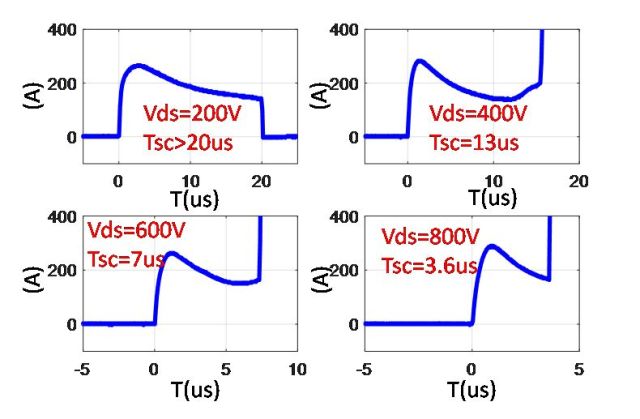
圖 6:不同直流漏極電壓下的短路
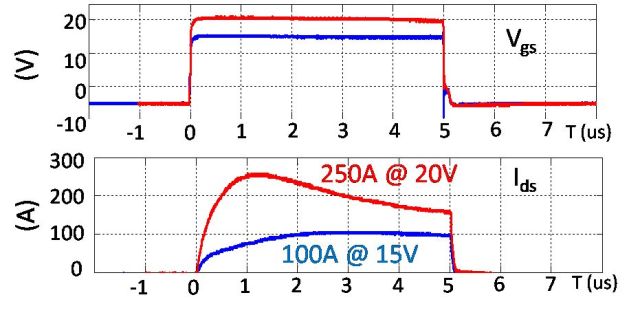
圖 7:不同柵極驅(qū)動(dòng)電壓下的短路
通過(guò)柵極驅(qū)動(dòng)器 IC 去飽和保護(hù)進(jìn)行短路保護(hù)
保護(hù) SiC MOSFET 免于短路故障需要柵極驅(qū)動(dòng)器檢測(cè)過(guò)流情況并在其耐受時(shí)間內(nèi)關(guān)閉 MOSFET?為 Si IGBT 器件開(kāi)發(fā)的幾種現(xiàn)成驅(qū)動(dòng)器 IC 提供集成的去飽和 (de-sat) 保護(hù)功能,可在導(dǎo)通狀態(tài)期間監(jiān)控 V DS并在發(fā)生過(guò)流事件時(shí)關(guān)閉器件?如果驅(qū)動(dòng)器 IC 響應(yīng)速度足夠快,則相同的驅(qū)動(dòng)器 IC 可用于 SiC MOSFET 的短路保護(hù)?
圖 8 顯示了用于通過(guò)各種驅(qū)動(dòng)器 IC 實(shí)現(xiàn)去飽和功能的電路?快速動(dòng)作 Si 二極管 (D D )在關(guān)斷狀態(tài)下阻止 V DS,齊納二極管 (D C ) 在開(kāi)關(guān)轉(zhuǎn)換期間保護(hù) de-sat 引腳,電容器 (C B) 控制消隱時(shí)間以避免在開(kāi)關(guān)瞬態(tài)期間誤觸發(fā)?圖 9 顯示了具有去飽和保護(hù)使能 IC 的短路事件波形?由于 SiC MOSFET 的快速開(kāi)關(guān)速度和所需的優(yōu)化功率回路布局,器件電壓和電流在瞬態(tài)事件后達(dá)到穩(wěn)態(tài)所需的時(shí)間比 IGBT 短得多?因此,基于 SiC 的設(shè)計(jì)中使用的驅(qū)動(dòng)器 IC 的去飽和功能所需的消隱時(shí)間也應(yīng)該更短?為了保護(hù) SiC MOSFET,通常選擇小于 100 pF的 C B并且消隱時(shí)間可以短至 200 ns,以減少驅(qū)動(dòng)器 IC 的總響應(yīng)時(shí)間?
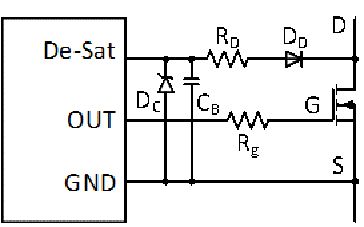
圖 8:去飽和實(shí)施

圖 9:去飽和保護(hù)瞬態(tài)
表 1 比較了具有 33 pF 消隱電容器的不同驅(qū)動(dòng)器 IC 的性能?結(jié)果表明,每個(gè) IC 都可以在 1–4 µs 內(nèi)在擊穿期間保護(hù) SiC MOSFET?它們中的每一個(gè)還具有“軟關(guān)斷”功能,可在短路條件下緩慢關(guān)斷器件,以保護(hù) MOSFET 和驅(qū)動(dòng) IC?
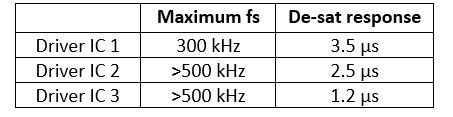
表 1:商用驅(qū)動(dòng)器 IC 評(píng)估
半橋配置中的短路保護(hù)
最后,具有最長(zhǎng)響應(yīng)時(shí)間的 SiC MOSFET 和柵極驅(qū)動(dòng)器 IC 在短路條件下在單器件和半橋配置中一起進(jìn)行了測(cè)試?圖 9a 和 9b 顯示了具有 800 V DC 總線(xiàn)電壓的擊穿瞬變期間的測(cè)試波形?在半橋配置中,頂部器件在整個(gè)瞬態(tài)期間保持開(kāi)啟,底部器件由具有去飽和功能的柵極驅(qū)動(dòng)器驅(qū)動(dòng)?
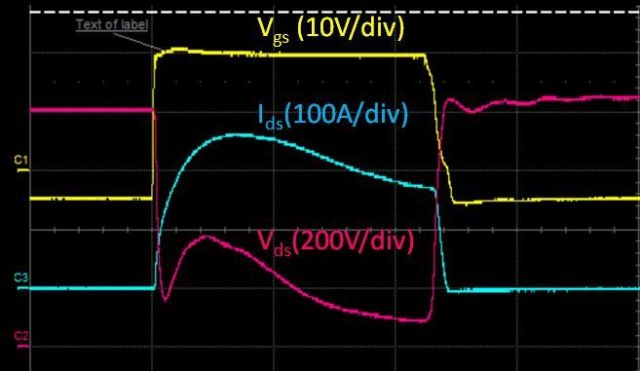
圖 10a:單個(gè)設(shè)備的擊穿保護(hù)
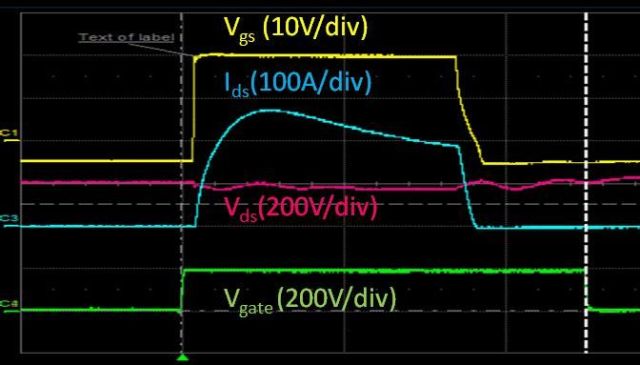
圖 10b:半橋配置中的擊穿保護(hù)
圖 10 中的結(jié)果表明,在兩種情況下都可以安全關(guān)閉 SiC MOSFET?結(jié)果還表明,在半橋配置中,直流母線(xiàn)電壓由兩個(gè)設(shè)備共享,每個(gè)設(shè)備的實(shí)際電壓遠(yuǎn)低于直流母線(xiàn)電壓,這為保護(hù)電路的反應(yīng)時(shí)間提供了更多的裕度?如果底部和頂部器件都具有擊穿保護(hù)功能,則任一器件都可以保護(hù)整個(gè)電路?


